近期,有不少半導(dǎo)體行業(yè)的客戶向小編咨詢,想要進(jìn)行檢微電子封裝金絲鍵合可靠性測(cè)試,該用什么設(shè)備?金線鍵合仍是主流互聯(lián)技術(shù)的今天,鍵合金絲的可靠性直接決定了微電子器件(如CPU、存儲(chǔ)器、功率器件等)的壽命與性能。在惡劣的工作環(huán)境下,如溫度循環(huán)、機(jī)械振動(dòng)等,金絲鍵合點(diǎn)可能因疲勞、柯肯德爾空洞、界面污染等原因?qū)е率Вl(fā)器件功能異常甚至徹di報(bào)廢。因此,對(duì)鍵合金絲進(jìn)行精確的失效分析,是提升產(chǎn)品良率、保障長(zhǎng)期可靠性的關(guān)鍵環(huán)節(jié)。
失效分析不僅在于“事后診斷",更在于“事前預(yù)防"和“過程監(jiān)控"。推拉力測(cè)試作為評(píng)估鍵合強(qiáng)度最直接、zui權(quán)wei的力學(xué)手段,是失效分析工具箱中的核心利器。本文科準(zhǔn)測(cè)控小編將圍繞Alpha W260推拉力測(cè)試機(jī),系統(tǒng)介紹金絲失效分析的原理、標(biāo)準(zhǔn)、設(shè)備與操作流程,助力廣大微電子工程師深入理解并掌握這一關(guān)鍵技術(shù)。
一、 分析原理
推拉力測(cè)試的基本原理是模擬和量化鍵合點(diǎn)在真實(shí)應(yīng)用中可能承受的機(jī)械應(yīng)力,通過施加一個(gè)精確可控的力,直至鍵合點(diǎn)失效,從而測(cè)得其強(qiáng)度極限。
1、拉力測(cè)試
目的: 評(píng)估金絲與芯片焊盤、管腳鍵合點(diǎn)(第一、第二焊點(diǎn))的粘附強(qiáng)度及金絲本身的抗拉強(qiáng)度。
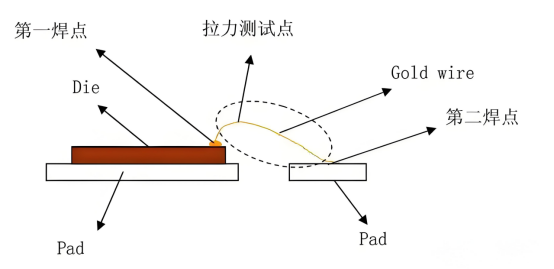
原理: 使用精密的鉤子(測(cè)試鉤)在鍵合絲弧的中點(diǎn)下方鉤住金絲,以一個(gè)恒定的速度垂直向上或水平方向拉伸,直至金絲被拉斷或鍵合點(diǎn)被拉脫。設(shè)備記錄下整個(gè)過程的最大力值,即為鍵合點(diǎn)的拉斷力。
2、推力測(cè)試:
目的: 評(píng)估金絲第一焊點(diǎn)(芯片側(cè))的抗剪切強(qiáng)度。
原理: 使用一個(gè)極細(xì)且平坦的推刀,對(duì)準(zhǔn)第一焊點(diǎn)的側(cè)面,以一個(gè)恒定的速度水平推進(jìn),將焊球從芯片焊盤上剪切下來。設(shè)備記錄下剪切過程中的最大力值,即為焊球的剪切力。
通過分析力值數(shù)據(jù)、失效力值大小以及失效模式(即斷裂/脫落的位置和形貌),可以準(zhǔn)確判斷鍵合工藝的質(zhì)量和潛在的失效機(jī)理。
二、 相關(guān)標(biāo)準(zhǔn)
MIL-STD-883 《微電子器件試驗(yàn)方法和程序》
JEDEC JESD22-B116 《線纜鍵合剪切試驗(yàn)標(biāo)準(zhǔn)》
GB/T 4937 《半導(dǎo)體器件機(jī)械和氣候試驗(yàn)方法》
三、 核心儀器
1、Alpha W260推拉力測(cè)試機(jī)

Alpha W260推拉力測(cè)試機(jī)是一款高精度、全自動(dòng)的鍵合強(qiáng)度測(cè)試系統(tǒng),專為微電子封裝失效分析和高可靠性測(cè)試而設(shè)計(jì)。
主要技術(shù)特點(diǎn)與優(yōu)勢(shì):
高精度力值傳感: 采用高分辨率、多量程的力傳感器,力值分辨率可達(dá)0.001克力,確保測(cè)試數(shù)據(jù)的精確性和重復(fù)性。
精密的運(yùn)動(dòng)控制: 搭載高精度步進(jìn)電機(jī)或伺服電機(jī),配合精密的傳動(dòng)機(jī)構(gòu),實(shí)現(xiàn)測(cè)試鉤/推刀的微米級(jí)定位,避免對(duì)樣品造成意外損傷。
強(qiáng)大的視覺系統(tǒng): 集成高倍率光學(xué)顯微鏡和CCD相機(jī),提供清晰的實(shí)時(shí)圖像,便于操作者精確尋找測(cè)試位置和觀察失效后的形貌。

四、 測(cè)試分析流程
步驟一:樣品準(zhǔn)備與安裝
將待測(cè)的封裝好的芯片樣品(如DIP、QFP、BGA等)牢固地固定在測(cè)試機(jī)的專用夾具上。
通過軟件控制平臺(tái),移動(dòng)樣品臺(tái),使待測(cè)鍵合絲清晰地出現(xiàn)在顯微鏡視野中央。
步驟二:測(cè)試程序設(shè)置
選擇測(cè)試模式: 根據(jù)分析目的,選擇“拉力測(cè)試"或“推力測(cè)試"模式。
參數(shù)設(shè)定:
拉力測(cè)試: 設(shè)置測(cè)試鉤類型、鉤絲高度、拉伸速度(通常為100-500 μm/s)等。
推力測(cè)試: 設(shè)置推刀類型、推刀高度(通常為焊球高度的1/4 - 1/2)、推進(jìn)速度、剪切距離等。
標(biāo)定與校準(zhǔn): 在測(cè)試前,對(duì)力傳感器和運(yùn)動(dòng)系統(tǒng)進(jìn)行校準(zhǔn),確保數(shù)據(jù)準(zhǔn)確。
步驟三:執(zhí)行測(cè)試
精確定位: 利用視覺系統(tǒng),將測(cè)試鉤或推刀精確移動(dòng)到預(yù)設(shè)的測(cè)試位置。
啟動(dòng)測(cè)試: 啟動(dòng)測(cè)試程序,設(shè)備將自動(dòng)完成施力過程。
數(shù)據(jù)記錄: 系統(tǒng)自動(dòng)記錄下最大力值(Fmax)和力-位移曲線。
步驟四:失效模式分析(關(guān)鍵步驟)
測(cè)試結(jié)束后,立即在顯微鏡下觀察失效位置,并根據(jù)標(biāo)準(zhǔn)進(jìn)行判定:
拉力測(cè)試常見失效模式:
導(dǎo)線斷裂: 斷裂點(diǎn)在金絲中間,表明金絲本身強(qiáng)度足夠,但可能存在頸縮或材料缺陷。
焊盤脫落: 鍵合點(diǎn)連同芯片焊盤金屬層被拉起,表明鍵合強(qiáng)度大于焊盤與基材的附著力,是芯片制造的缺陷。
界面失效: 鍵合點(diǎn)從焊盤上完整脫落,界面潔凈,表明鍵合界面結(jié)合力弱(可能因污染、氧化或參數(shù)不當(dāng)導(dǎo)致)。
推力測(cè)試常見失效模式:
焊球剪切: 焊球被wan全推離焊盤。
焊盤剝離: 焊盤金屬層被破壞。
** cratering:** 硅芯片基底被壓碎,這是最嚴(yán)重的缺陷,表明鍵合工藝能量過高。
步驟五:數(shù)據(jù)統(tǒng)計(jì)與報(bào)告生成
對(duì)同一批次的多個(gè)樣品進(jìn)行測(cè)試,統(tǒng)計(jì)平均力值、標(biāo)準(zhǔn)差和CPK值,評(píng)估工藝穩(wěn)定性。
結(jié)合力值數(shù)據(jù)和失效模式,綜合判斷鍵合工藝的薄弱環(huán)節(jié)。
使用設(shè)備軟件生成包含力值曲線、失效圖片和統(tǒng)計(jì)結(jié)果的綜合性測(cè)試報(bào)告。
以上就是小編介紹的有關(guān)于微電子封裝用鍵合金絲失效分析相關(guān)內(nèi)容了,希望可以給大家?guī)韼椭H绻€對(duì)推拉力測(cè)試機(jī)怎么使用視頻和圖解,使用步驟及注意事項(xiàng)、作業(yè)指導(dǎo)書,原理、怎么校準(zhǔn)和使用方法視頻,推拉力測(cè)試儀操作規(guī)范、使用方法和測(cè)試視頻,焊接強(qiáng)度測(cè)試儀使用方法和鍵合拉力測(cè)試儀等問題感興趣,歡迎關(guān)注我們,也可以給我們私信和留言。【科準(zhǔn)測(cè)控】小編將持續(xù)為大家分享推拉力測(cè)試機(jī)在鋰電池電阻、晶圓、硅晶片、IC半導(dǎo)體、BGA元件焊點(diǎn)、ALMP封裝、微電子封裝、LED封裝、TO封裝等領(lǐng)域應(yīng)用中可能遇到的問題及解決方案。